10月7日,三星電子宣布已開發(fā)出業(yè)界首個12層3D-TSV技術(shù)。
該技術(shù)被認(rèn)為是大規(guī)模生產(chǎn)高性能芯片最具挑戰(zhàn)性的封裝技術(shù)之一,因為它需要精確的定位才能通過60,000多個TSV孔的三維結(jié)構(gòu)垂直互連12個DRAM芯片,且厚度只有頭發(fā)的二十分之一。
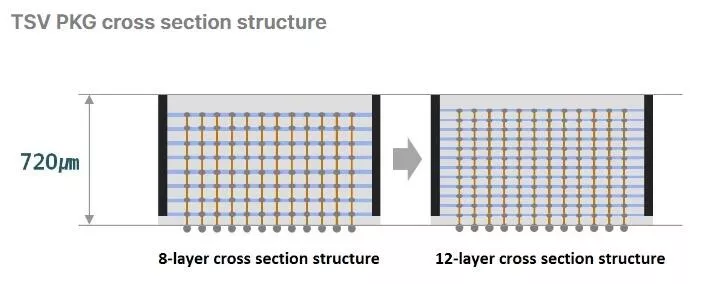
Source:三星
封裝的厚度(720μm)與當(dāng)前的8層高帶寬存儲器HBM2產(chǎn)品相同,這在組件設(shè)計上是一項重大進(jìn)步,將幫助客戶發(fā)布具有更高性能容量的下一代大容量產(chǎn)品,而無需更改其系統(tǒng)配置設(shè)計。
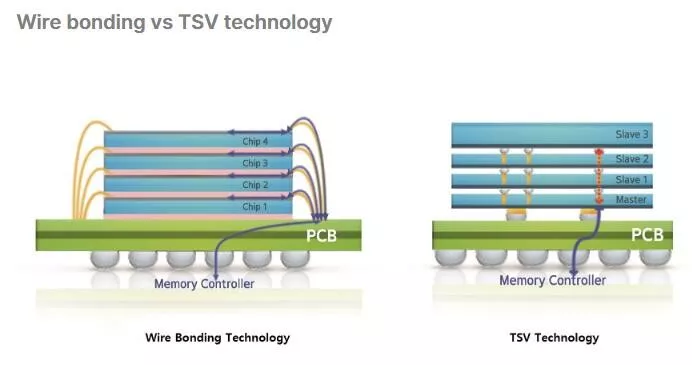
Source:三星
此外,3D封裝技術(shù)還具有比當(dāng)前現(xiàn)有的引線鍵合技術(shù)短的芯片間數(shù)據(jù)傳輸時間,從而顯著提高了速度并降低了功耗。
三星電子TSP(測試與系統(tǒng)封裝)執(zhí)行副總裁Hong-Joo Baek表示: “隨著各種新時代的應(yīng)用,例如人工智能(AI)和高功率計算(HPC),確保超高性能存儲器的所有復(fù)雜性的封裝技術(shù)變得越來越重要。”
憑借其12層3D-TSV技術(shù),三星將為數(shù)據(jù)密集型和超高速應(yīng)用提供最高的DRAM性能。而且,通過將堆疊層數(shù)從8個增加到12個,三星很快將能夠批量生產(chǎn)24GB高帶寬內(nèi)存,其容量是當(dāng)今市場上8GB高帶寬內(nèi)存的三倍。
三星將憑借其尖端的12層3D TSV技術(shù)滿足快速增長的大容量HBM解決方案市場需求,并希望鞏固其在高端半導(dǎo)體市場的領(lǐng)先地位。






