為了應(yīng)對(duì)環(huán)境污染,實(shí)現(xiàn)綠色可持續(xù)發(fā)展目標(biāo),作為清潔能源的電力成為世界各國關(guān)注的焦點(diǎn),能源利用電氣化成為發(fā)展的方向。在電力應(yīng)用領(lǐng)域中,實(shí)現(xiàn)能源控制與轉(zhuǎn)換的大功率電子器件當(dāng)之無愧是的核心部件之一。隨著功率模塊器件不斷朝著高功率密度、高工作溫度方向快速發(fā)展,具備更高可靠性的活性金屬釬焊氮化硅覆銅陶瓷基板已成為行業(yè)熱門選擇。
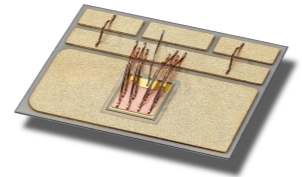
基于賀利氏活性金屬釬焊(AMB)覆銅氮化硅陶瓷基板的測(cè)試樣品
活性金屬釬焊氮化硅覆銅陶瓷基板行業(yè)內(nèi)一般簡(jiǎn)稱為AMB(Active Metal Brazed)基板,指的是通過活性金屬釬焊實(shí)現(xiàn)銅和氮化硅陶瓷連接,通過蝕刻減銅實(shí)現(xiàn)定制化銅箔圖案的電路基板,不僅為功率電子元器件提供支撐并實(shí)現(xiàn)電氣連接,更為模塊熱管理做出重要貢獻(xiàn)。AMB基板作為功率模塊的重要基礎(chǔ)部件,成本占比不高,但是面臨復(fù)雜嚴(yán)苛的生產(chǎn)和使用條件,行業(yè)對(duì)其高質(zhì)量、穩(wěn)定性提出了越來越高的要求。
AMB基板主要是三明治結(jié)構(gòu):上、下層銅通過釬焊附著于陶瓷,上層銅負(fù)責(zé)連接承載電子元器件,下層銅負(fù)責(zé)連接散熱器件。不同于一般工業(yè)領(lǐng)域熟知的PCB(印刷電路板,盡管他們功能原理上非常相似)、數(shù)控機(jī)加工件、鈑金折彎件、磨具注塑等加工體系成熟的工業(yè)零部件,AMB基板生產(chǎn)流程和加工方式更復(fù)雜、涉及細(xì)節(jié)更多,其重點(diǎn)和難點(diǎn)主要在陶瓷材料、釬焊工藝、蝕刻和表面處理三個(gè)方面。

活性金屬釬焊(AMB)覆銅氮化硅陶瓷基板斷面結(jié)構(gòu)示意圖
氮化硅陶瓷
作為AMB基板的絕緣層材料,氮化硅陶瓷有著優(yōu)異的導(dǎo)熱率和絕緣性能,其高強(qiáng)度、高韌性、耐高溫、可靠性高等優(yōu)異的綜合熱力學(xué)性能成為先進(jìn)功率電子模塊首選。但是氮化硅陶瓷的生產(chǎn)需要嚴(yán)格的工藝條件控制,氮化硅基板晶粒和晶界的數(shù)量關(guān)系、孔隙率(致密度)、微缺陷控制、原材料要求和工藝潔凈度都對(duì)最終產(chǎn)品有著重要的影響。賀利氏與陶瓷材料供應(yīng)商通力合作,采用得到廣泛驗(yàn)證的產(chǎn)品作為原材料,訂立嚴(yán)格的產(chǎn)品標(biāo)準(zhǔn)。同時(shí)賀利氏也在工廠內(nèi)部建立質(zhì)量管控如SAT掃描和高壓ISO測(cè)試等措施,為有需要的客戶進(jìn)一步降低可能存在的風(fēng)險(xiǎn)。
釬焊連接技術(shù)
釬焊是一種古老的連接技術(shù),陶瓷和金屬連接的關(guān)鍵在釬焊。由于陶瓷和金屬的物理化學(xué)性質(zhì)差異大陶瓷和金屬釬料難以潤(rùn)濕,釬焊過程中利用釬料中的活性金屬元素(Ti、Zr、Ta、Nb、V、Hf 等)和陶瓷母材界面反應(yīng),通過金屬性反應(yīng)物實(shí)現(xiàn)焊料合金與陶瓷結(jié)合的同時(shí)提高陶瓷表面潤(rùn)濕特性。焊料合金和銅層母材金屬形成合金,通過金屬鍵緊密連接起來,從而最終達(dá)到銅和陶瓷結(jié)合的效果。
傳統(tǒng)的Ag-Cu-Ti釬焊料中往往含銀量可達(dá)60%,對(duì)用戶而言是一個(gè)不小的成本負(fù)擔(dān),而賀利氏基于其創(chuàng)新的獨(dú)有技術(shù),突破性地實(shí)現(xiàn)了無銀釬焊料釬焊工藝,從而強(qiáng)化了AMB基板的成本優(yōu)勢(shì)并且避免了銀遷移風(fēng)險(xiǎn)。

賀利氏推出的Condura®.ultra無銀活性金屬釬焊(AMB)覆銅氮化硅陶瓷基板
蝕刻和表面處理
蝕刻是借助物理化學(xué)手段選擇性移除銅的過程。在工業(yè)領(lǐng)域如PCB和半導(dǎo)體行業(yè)中蝕刻是一項(xiàng)比較成熟和常見的工藝,適合制作非常精密的結(jié)構(gòu)和圖案,但AMB基板中的蝕刻則顯然有一些不同之處:AMB基板常用的銅厚一般為0.3mm~0.8mm, 這一尺寸范圍遠(yuǎn)遠(yuǎn)大于前述蝕刻的目標(biāo)材料層厚度。由于化學(xué)濕法蝕刻的特性,尺寸精度和蝕刻因子以及能否在大批量生產(chǎn)中保證一致性是業(yè)內(nèi)關(guān)注的重要指標(biāo)。

蝕刻后斷面結(jié)構(gòu)示意圖
通過不同的表面處理,確保銅表面能夠適應(yīng)器件連接和封裝等工藝要求。賀利氏具有數(shù)十年的覆銅陶瓷板生產(chǎn)歷史和強(qiáng)大的燒結(jié)、焊接材料和線材產(chǎn)品線,不斷深耕的經(jīng)驗(yàn)累積讓賀利氏有信心為客戶提供最佳的產(chǎn)品。
賀利氏電子是電子行業(yè)內(nèi)提供創(chuàng)新解決方案的元器件封裝材料制造商,為汽車、功率電子和先進(jìn)半導(dǎo)體封裝市場(chǎng)開發(fā)材料解決方案。公司在亞洲、美國和歐洲擁有8個(gè)研發(fā)中心和生產(chǎn)設(shè)施。作為解決方案供應(yīng)商,賀利氏電子為客戶提供從材料和料系統(tǒng)到元器件和技術(shù)服務(wù)的廣泛產(chǎn)品組合。






