SEMICON China 2019已經(jīng)落下帷幕,期間來自海內(nèi)外的IC設(shè)計、制造、封測、設(shè)備、材料等產(chǎn)業(yè)鏈供應(yīng)者齊聚上海共襄盛會,TrendForce集邦咨詢將從IC封裝技術(shù)及封測設(shè)備分析中國IC封測產(chǎn)業(yè)發(fā)展動態(tài)。
晶圓級先進封裝技術(shù)是各大封測廠商技術(shù)必爭目標(biāo)
今年SEMICON上海展N5館中國大陸三大封測廠及晶方科技皆有參展,各大封測廠的展示重點主要是顯現(xiàn)企業(yè)自身所具備的封裝技術(shù)的多樣性及完整性,尤其凸顯晶圓級封裝技術(shù)及SiP技術(shù),具備晶圓級先進封裝量產(chǎn)能力成為專業(yè)IC封測代工業(yè)者(OSAT)的技術(shù)競爭目標(biāo),而具備SiP封裝技術(shù)則體現(xiàn)對潛在客戶的客制化能力。
從技術(shù)特點上來看,晶圓級封裝技術(shù)可分為FIWLP(Fan-In WLP扇入型晶圓級封裝)、FOWLP(Fan-Out WLP扇出型晶圓級封裝)兩種,相對于FI,F(xiàn)O可不受芯片面積的限制,將I/O bumping通過RDL層擴展至IC芯片周邊,在滿足I/O數(shù)增大的前提下又不至于使Ball pitch過于縮小。
圖表1 FIWLP與FOWLP示意圖

資料來源:集邦咨詢,2019.04
目前晶圓級封裝約占整個先進封裝(主要包括Flip Chip、Embedded Die in Substrate、FIWLP、FOWLP、2.5D/3D)20%的份額,扇入型封裝器件主要為WiFi/BT集成組件、收發(fā)器、PMIC和DC/DC轉(zhuǎn)換器,全球主要參與者日月光、矽品、長電科技、德州儀器、安靠、臺積電約占全球FIWLP 60%的份額。而扇出型封裝可分為低密度扇出型封裝(小于500個I/O、超過8um的線寬線距)及高密度扇出型封裝,其中低密度扇出型封裝主要用于基頻處理器、電源管理芯片、射頻收發(fā)器,高密度扇出型封裝主要用于AP、存儲器等具備大量I/O接腳的芯片。相對而言,扇出型晶圓級封裝的參與者較少,長電科技、臺積電、安靠、日月光約占全球85%的份額。
值得一提的是,扇出型封裝新進玩家華天科技繼推出自有IP特色的eSiFO技術(shù)后,于今年的SEMICON China新技術(shù)發(fā)布會上推出了eSinC(埋入集成系統(tǒng)級芯片,Embedded System in Chip)技術(shù)。eSinC技術(shù)同樣采用在硅基板上刻蝕形成凹槽,將不同芯片或元器件放入凹槽中,通過高密度RDL將芯片互連,形成扇出的I/O后制作via last TSV實現(xiàn)垂直互連。eSinC可以將不同功能、不同種類和不同尺寸的器件實現(xiàn)3D方向高密度集成。
圖表2 華天科技eSinC示意圖

資料來源:華天科技,集邦咨詢,2019.04
隨著未來電子產(chǎn)品高性能、小尺寸、高可靠性、超低功耗的要求越來越高,晶圓級封裝憑借固有的、無可比擬的最小封裝尺寸和低成本(無需載板)相結(jié)合的優(yōu)勢,將驅(qū)使晶圓級封裝技術(shù)應(yīng)用到更多的新興的細(xì)分市場,比如5G毫米波器件、MEMS、ADAS汽車應(yīng)用等領(lǐng)域。
關(guān)于未來晶圓級封裝發(fā)展,TrendForce集邦咨詢認(rèn)為:
1)具有前道工藝的代工廠在先進封裝技術(shù)研發(fā)方面具有技術(shù)、人才和資源優(yōu)勢,因此在高密度扇出型集成(尤其在3D集成)方面將來還是以Foundry廠主導(dǎo),臺積電將是主要的引領(lǐng)者;
2)在扇入型及低密度扇出型方面主要以O(shè)SAT、IDM為主,而且隨著時間的推移,進入的OSAT廠將越來越多,各企業(yè)將展開差異化競爭;
3)為了進一步降低封裝成本,不少廠商在做panel-based研發(fā),預(yù)計兩年后的SEMICON China將出現(xiàn)panel-based技術(shù)的發(fā)布。
先進封裝有望帶動國產(chǎn)設(shè)備進一步提高國產(chǎn)率
本次SEMICON China有關(guān)封裝設(shè)備的展覽中,傳統(tǒng)封裝設(shè)備以國際大廠設(shè)備為主,而在先進封裝領(lǐng)域則中國廠商展覽數(shù)目較多,包括北方華創(chuàng)、上海微電子、中微半導(dǎo)體、盛美半導(dǎo)體等,其中北方華創(chuàng)可為Flip Chip Bumping、FI、FO等封裝技術(shù)提供UBM/RDL PVD以及為2.5D/3D封裝提供高深寬比TSV刻蝕、TSV PVD工藝設(shè)備;上海微電子展示用于先進封裝的500系列步進投影光刻機;盛美半導(dǎo)體則發(fā)布了先進封裝拋銅設(shè)備和先進封裝電鍍銅設(shè)備。
先進封裝生產(chǎn)過程中將用到光刻機、蝕刻機、濺射設(shè)備等前道設(shè)備,但是相對于前道制造設(shè)備,先進封裝所用設(shè)備的精度、分辨率等要求相對較低,以光刻機為例,上海微電子用于先進封裝所用步進光刻機分辨率約為其用于前段制造光刻機分辨率的十分之一。
根據(jù)集邦咨詢統(tǒng)計,2018年中國先進封裝銷售額為179.2億元,約占2018年中國封測總銷售額的8.9%,遠(yuǎn)低于全球先進封裝比例30%,未來中國先進封裝的成長空間巨大,中國設(shè)備廠商在不斷研發(fā)前段設(shè)備的同時,切入精度、分辨率較低的后段設(shè)備,是帶動國產(chǎn)設(shè)備進一步提升國產(chǎn)率的一大機遇。
圖表3 扇出型晶圓級封裝所用設(shè)備及主要廠商
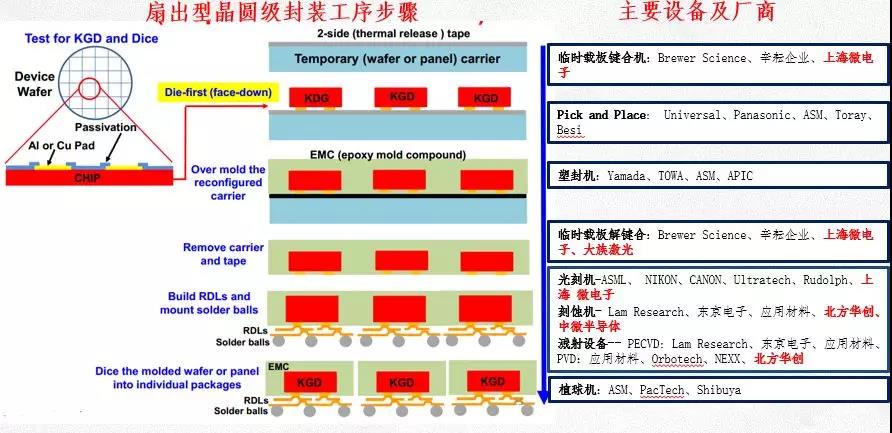
資料來源:集邦咨詢,2019.04
國產(chǎn)測試機設(shè)備廠暫難以在AI、5G新興產(chǎn)業(yè)相關(guān)主題中分一杯羹
在本次展會上,國際測試機龍頭企業(yè)愛德萬(Advantest)、泰瑞達(dá)(Teradyne)推出在AI、5G等新興產(chǎn)業(yè)中先進的測試解決方案,其中愛德萬V93000可擴充式平臺,具備每腳位1.6Gbps快速的資料傳輸速率、主動式溫度控制(ATC)等功能,采用最新IC測試解決方案和服務(wù)來支持AI技術(shù);而Teradyne重點推出的適用于AI及5G測試機US60G可達(dá)60Gbps串行接口測試。
目前全球集成電路FT測試機主要掌握在美日廠商手中,美國泰瑞達(dá)、科休和日本愛德萬約占全球FT測試設(shè)備80%市場份額。中國本土企業(yè)如長川科技、北京華峰測控雖通過多年的研究和積累,在模擬/數(shù)模測試和分立器件測試領(lǐng)域已經(jīng)開始實現(xiàn)進口替代,但在SoC和存儲等對測試要求較高的領(lǐng)域尚未形成成熟的產(chǎn)品和市場突破,基本只用于中國本土封測廠中低端測試領(lǐng)域。
如今在AI、5G等新興產(chǎn)業(yè)下,芯片集成度更高、測試機模塊更多,國際寡頭憑借技術(shù)優(yōu)勢、人才優(yōu)勢、市場優(yōu)勢,大有強者恒強的趨勢。同時由于在SoC芯片測試領(lǐng)域涉及到算法、硬件設(shè)計、結(jié)構(gòu)設(shè)計等多個領(lǐng)域技術(shù)的綜合運用,在單一平臺上實現(xiàn)多功能的全面綜合測試且有效控制測試時間,存在非常高的技術(shù)壁壘,本土企業(yè)起步較晚,需要通過自主創(chuàng)新進行整體系統(tǒng)研發(fā),在高端測試領(lǐng)域?qū)崿F(xiàn)國產(chǎn)化道路遠(yuǎn)阻。
備注:以上內(nèi)容為集邦咨詢TrendForce原創(chuàng),禁止轉(zhuǎn)載、摘編、復(fù)制及鏡像等使用,如需轉(zhuǎn)載請聯(lián)系我們?nèi)〉檬跈?quán)。






